TSMC's nye COUPE tech klar i 2026
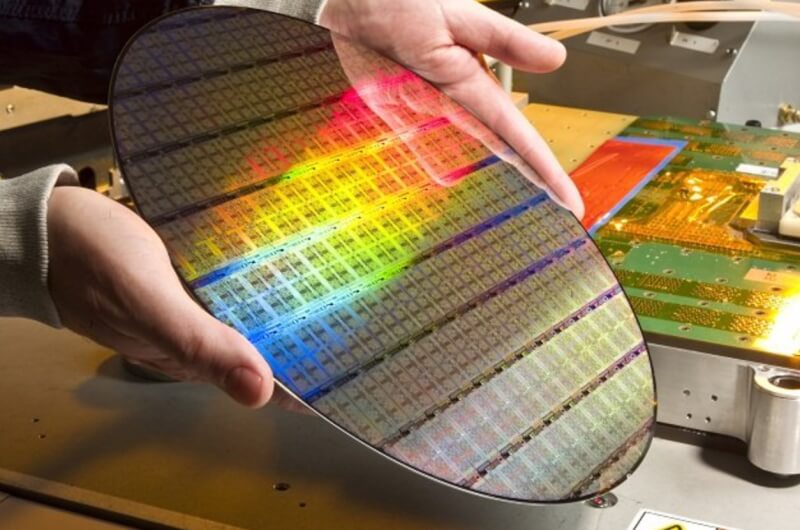
Taiwan Semiconductor Manufacturing Company (TSMC) har afsløret sin nyeste halvlederproces, avanceret packaging og 3D IC-teknologier til næste generation af AI-innovationer ved TSMC's Technology Symposium i Nordamerika i 2024. Ved arrangementet afslørede TSMC sin nye A16-teknologi, der indeholder brancheførende nanosheet-transistorer med en innovativ løsning til strømforsyning på bagsiden til produktion i 2026, med "betydeligt forbedret logiktæthed og ydeevne.
TSMC introducerede også sin nye System-on-Wafer (TSMC-SoW) teknologi, der er en innovativ løsning, som leverer "revolutionerende ydeevne på wafel-niveau" i forhold til fremtidens AI-krav for hyperscaler datacentre. Den næste generation COUPE-teknologi bruger SoIC-X chip-stacking teknologi til at stable en elektrisk chip oven på en fotonic chip, hvilket ifølge TSMC vil tilbyde den laveste impedans ved chip-til-chip grænsefladen og højere energieffektivitet end konventionelle metoder.
TSMC har planer om at kvalificere COUPE til small form factor pluggables i 2025, hvilket vil blive fulgt af integration i CoWoS packaging som co-packaged optik (CPO) i 2026, hvilket bringer optiske forbindelser direkte ind i chippakken. TSMC har også antydet, at de arbejder på en ny teknologi, der vil forsyne chips med strøm fra bagsiden af selve chippen, hvilket vil fremskynde AI-chips og andre processorer i 2026 og fremover. TSMC forklarede i deres pressemeddelelse: "TSMC udvikler Compact Universal Photonic Engine (COUPE™) teknologi til at understøtte den eksplosive vækst i datatransmission, der følger med efterspørgelen på AI technologi.
COUPE bruger SoIC-X chip-stacking teknologi til at stable en elektrisk chip oven på en fotonic chip, hvilket tilbyder den laveste impedans ved chip-til-chip grænsefladen og højere energieffektivitet end konventionelle metoder. TSMC planlægger at kvalificere COUPE til small form factor pluggables i 2025, efterfulgt af integration i CoWoS emballage som co-packaged optik (CPO) i 2026, hvilket bringer optiske forbindelser direkte ind i pakken.
Seneste processor
-
17 majprocessor
-
16 majprocessor
Nvidias Blackwell bliver en dyr affære
-
15 majprocessor
Google lancerer Trillium-chip, forbedrer AI-datace
-
13 majprocessor
Snapdragon 8 Gen 4 får muligt boost
-
08 majprocessor
Apple ønsker egne AI chips
-
08 majprocessor
Apple hævder deres AI vil slå PC'er
-
07 majprocessor
Intel snart klar med Arrow Lake-S
-
01 majprocessor
AMD AI-chip indtjening skuffer, aktier falder 7%









